多光子励起過程を用いた次世代半導体の非破壊評価技術

キーワード
多光子顕微鏡、結晶成長、結晶欠陥、次世代半導体、 評価技術
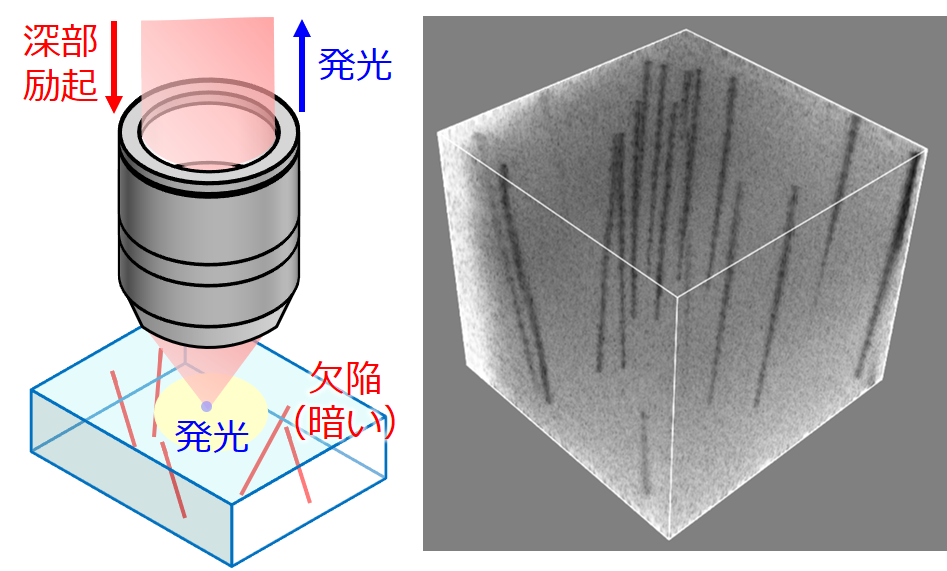
ここがポイント!【研究内容】
GaNやSiCなどをはじめとした次世代半導体を用いたデバイスがエレクトロニクス産業に普及されるためには、結晶欠陥の理解が極めて重要です。試料に超短パルスレーザを照射すると、結晶の物性に由来した非線形光学現象が起こります。この現象を経て放出される光を検出することで、結晶を破壊することなく欠陥の三次元イメージングが可能となります。観察された欠陥の三次元像には固有の性質が現れており、欠陥種の識別や分類が可能です。本技術により次世代半導体の材料開発を飛躍的に加速させることができます。
応用分野
次世代半導体開発、パワーデバイス分野、レーザ分野
論文・解説等
- [1] M. Tsukakoshi, T. Tanikawa, et al., Appl. Phys. Express 14 (2021) 055504.
- [2] T. Tanikawa et al., Appl. Phys. Express 11 (2018) 031004.
- [3] 谷川他,応用物理 89 (2020) 524.




 ご相談・お問い合わせ
ご相談・お問い合わせ



